四川省通信学会 四川省通信行业协会
四川省通信学会四川省通信行业协会,四川省通信学会四川省通信行业协会

2024年晶圆代工年增12%,先进制程力挺台积电成一个人的武林,市调机构集邦科技表示,2024年全球晶圆代工市场预估将有12%成长,然而,在这些成长中,扣除了台积电之后,其全年成长仅将有3.6%幅度。因此,2024年的全球求晶圆代工市场可说是台积电“一个人的武林”。而在成熟制程方面,价格仍是厂商间竞争的重点,差异化则会是未来厂商努力趋势。29日在“AI应用拓新局,半导体技术挑战”的论坛上,集邦科技研究副理乔安指出,在经历2023年一年的低迷之后,晶圆代工市场终于在2024年迎接复苏状态。就全

高通重磅发布第三代S5和S3音频平台,3月26日,高通发布了两大全新的先进音频平台,第三代高通S3音频平台和第三代高通S5音频平台,分别面向中端和高端耳机产品。它可以帮助使制造商在更广泛的蓝牙音频产品中实现发烧友级的音质、增强的ANC、改进的通话质量和更低的功耗。高通的新款音频芯片包含新的人工智能功能,第三代S5音频平台首次配备了人工智能驱动的神经处理单元(NPU)。理论上,在NPU中使用AI应该可以让耳机更快、更高效且功耗更低地处理降噪、透明度和外部噪声管理等

【2024年3月26日,德国慕尼黑和加利福尼亚州圣何塞讯】全球功率系统和物联网领域的领导者英飞凌科技股份公司(FSE代码:IFX/OTCQX代码:IFNNY)于2月25日至29日参加2024年美国国际电力电子应用展览会(APEC),并重点展示其在业界非常全面的功率电子器件。,【2024年3月26

近日,英国半导体公司PragmaticSemiconductor正式启用其位于达勒姆(Durham)的最新工厂。该公司表示,这是英国首个生产300毫米半导体芯片的工厂。, 近日,英国半导体公司PragmaticSemiconductor正式启用其位于达勒姆(Durham)的最新工厂。该公司表示,这是英国首个生产300毫米半导体芯片的工厂。 PragmaticPark预期将在未来五年内创造500

据阜新日报报道,辽宁晶测科技有限公司(以下简称“晶测科技”)年检测30万支国产化芯片项目已完成办公区和实验区装修改造工程,检测设备全部进场,预计4月初即可进入试运营阶段。, 据阜新日报报道,辽宁晶测科技有限公司(以下简称“晶测科技”)年检测30万支国产化芯片项目已完成办公区和实验区装修改造工程,检测设备全部进场,预计4月初即可进入试运营阶段。 晶测科技年检测30万支国产化芯片项目总投资5300万元,

据南京日报报道,3月28日,天水华天电子集团在浦口签约落户华天南京集成电路先进封测产业基地二期项目。, 据南京日报报道,3月28日,天水华天电子集团在浦口签约落户华天南京集成电路先进封测产业基地二期项目。 华天南京集成电路先进封测产业基地项目(一期)2020年7月正式投产,去年实现产值29亿元。基于前期良好的合作基础,华天集团再投资100亿元,启动二期项目,新建20万平方米的厂房及配套设施,新引进高

盘点国产GPU在支持大模型应用方面的进展,GPU,大家首先想到的应该就是英伟达了。近一年多时间来,随着大模型的发展,英伟达GPU的强大实力可谓无人不知。而相比之下,国产GPU的声势就小了许多。事实上,近些年国内也有不少GPU企业在逐步成长,虽然在大模型的训练和推理方面,与英伟达GPU差距极大,但是不可忽视的是,不少国产GPU企业也在AI的训练和推理应用上找到位置。景嘉微景嘉微是国产GPU市场的主要参与者,目前已经完成JM5、JM7和JM

3月28日,兆易创新发布公告称,长鑫科技目前正在开展新一轮股权融资,公司拟以自有资金15亿元人民币参与长鑫科技本轮增资。, 3月28日,兆易创新发布公告称,长鑫科技目前正在开展新一轮股权融资,公司拟以自有资金15亿元人民币参与长鑫科技本轮增资。 根据公告,兆易创新将与长鑫科技、早期股东合肥长鑫集成电路有限责任公司(以下简称“长鑫集成”)、合肥清辉集电企业管理合伙企业(有限合伙)和合肥集鑫企业管理合伙

据合肥新站区消息,3月26日,威迈芯材(合肥)半导体有限公司年产100吨半导体高端光刻材料项目奠基仪式在新站高新区举行。, 据合肥新站区消息,3月26日,威迈芯材(合肥)半导体有限公司年产100吨半导体高端光刻材料项目奠基仪式在新站高新区举行。 消息显示,威迈芯材(合肥)半导体有限公司是苏州威迈的全资子公司,位于新站高新区颍州路与龙子湖路交口,占地面积共50亩,总投资3亿元,旨在打造国内最大的高端半

3月26日,南亚新材发布公告称,基于整体战略布局及经营发展的需要,为加快产能规划及产业布局,公司拟投资建设高端电子电路基材基地建设项目。, 3月26日,南亚新材发布公告称,基于整体战略布局及经营发展的需要,为加快产能规划及产业布局,公司拟投资建设高端电子电路基材基地建设项目。 高端电子电路基材基地建设项目总投资12亿元,由南亚新材全资子公司江苏南亚实施,拟在江苏省海门经济技术开发区购置土地建设新的生
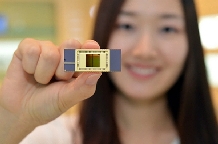
3月27日,美光宣布其位于西安的封装和测试新厂房已正式破土动工。, 3月27日,美光宣布其位于西安的封装和测试新厂房已正式破土动工。 资料显示,美光在中国运营版图包括北京、上海、深圳与西安等地。2023年6月美光宣布在西安追加投资43亿元人民币,其中包括加建这座新厂房,引入全新产线,制造更广泛的产品解决方案,包括但不限于移动DRAM、NAND及SSD,从而拓展西安工厂现有的DRAM封装和测试能力。

人工智能、高性能计算、超大规模数据中心等领域,对芯片性能和功能提出了越来越高的要求。传统芯片设计和制造模式已经难以满足这些需求。,人工智能、高性能计算、超大规模数据中心等领域,对芯片性能和功能提出了越来越高的要求。传统芯片设计和制造模式已经难以满足这些需求。小芯片(Chiplet)和异构集成的Multi-Die系统,为解决这些难题带来了新的希望。 通过在单个封装中异构集成多个芯片,Multi-Die 系统能够提供更优异的处理能力和性能表现。一系列技术创新

2024年3月27日,于英国Clacton-on-Sea。高性能舌簧继电器的领先制造商PickeringElectronics宣布推出最新的大功率舌簧继电器,额定功率高达80w,以0.25英寸间距可紧密排布,称为144系列。,2024年3月27日,于英国Clacton-on-Sea。高性能舌簧继电器的领先制造商Pickering Electronics宣布推出最新的大功率舌簧继电器,额定功率高达80w,以0.

AI浪潮之下,先进封装需求上涨,此前封测大厂长电科技两大股东筹划股权转让,引起业界热议。昨日,这场话题迎来了答案!, AI浪潮之下,先进封装需求上涨,此前封测大厂长电科技两大股东筹划股权转让,引起业界热议。昨日,这场话题迎来了答案! 中国华润变更为长电科技实际控制人 2024年3月26日晚间,长电科技发布公告称,公司股东国家集成电路产业投资基金股

近日,韩国媒体报道称,三星或将向英伟达独家供应12层HBM3E。报道指出,英伟达最快将从9月开始大量购买三星电子的12层HBM3E,后者将向英伟达独家供应12层HBM3E。, 近日,韩国媒体报道称,三星或将向英伟达独家供应12层HBM3E。报道指出,英伟达最快将从9月开始大量购买三星电子的12层HBM3E,后者将向英伟达独家供应12层HBM3E。 据媒体报道,英伟达CEO黄仁勋近期在GTC2024
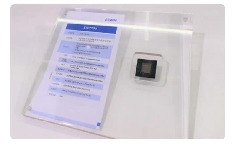
显示是与半导体高度融合的产业,显示是与半导体高度融合的产业。一方面,新型显示的蓬勃发展为半导体产业带来新的市场增量;另一方面,半导体技术的进步推动了显示产品的性能提升和场景创新。在前不久举行的SEMICON /FPD China2024上,京东方科技集团董事长陈炎顺表示,半导体产业和显示产业的紧密联系可从三个方面观察。首先是半导体产品技术能够赋能显示产

3月23日,湖北黄石市人民政府和闻泰科技共同主办了“闻泰科技2024年全球精英合作伙伴大会暨黄石光电子信息产业生态发布会”,共有51个产业项目集中签约,总投资高达507.9亿元。 , 3月23日,湖北黄石市人民政府和闻泰科技共同主办了“闻泰科技2024年全球精英合作伙伴大会暨黄石光电子信息产业生态发布会”,共有51个产业项目集中签约,总投资高达507.9亿元。 其中,现场有31个产业项目分4批集中签

近期,国内又一批半导体产业项目迎来新动态,涉及华天科技、伟测半导体、芯源微、天科合达、长晶半导体、芯粤能、先导半导体、鼎龙股份、安集科技等企业,项目涵盖光刻胶、半导体封装、晶圆制造、第三代半导体、半导体设备、芯片设计等重点领域。, 近期,国内又一批半导体产业项目迎来新动态,涉及华天科技、伟测半导体、芯源微、天科合达、长晶半导体、芯粤能、先导半导体、鼎龙股份、安集科技等企业,项目涵盖光刻胶、半导体封装、晶圆制造、第三

3月25日,日本半导体设备协会(SEAJ)公布统计最新数据。, 3月25日,日本半导体设备协会(SEAJ)公布统计最新数据。

3月22日,据高测股份官微消息,其8英寸半导体金刚线切片机再签新订单,设备交付后将发往欧洲某半导体企业,这是高测股份半导体设备收获的首个海外客户。, 3月22日,据高测股份官微消息,其8英寸半导体金刚线切片机再签新订单,设备交付后将发往欧洲某半导体企业,这是高测股份半导体设备收获的首个海外客户。 高测股份表示,此次合作客户是当地最大的单晶硅板制造商以及领先的紫外线医疗设备和LED设备制造商之一,高测

全球首台光学拆键合设备发布,和激光拆键合有什么不同?,在芯片制造的过程中,拆键合是非常重要的一步。拆键合工艺是通过施加热量或激光照射将重构的晶圆与载板分离。在此过程中,热敏或紫外线敏感胶带层会软化并失去附着力,从而有助于将晶圆与载板分离。当前,激光拆键合是主要的拆键合技术发展方向。激光拆键合技术是将临时键合胶通过旋涂的方式涂在器件晶圆上,并配有激光响应层,当减薄、TSV加工和金属化等后面工艺完成之后,再通过激光扫描的方式,分离超薄器件与载片,实现超薄器件的顺利加工,最后进行清洗。

贺利氏通过投资巩固其在创新材料技术领域的地位,持续加强多元化产品组合 -化合积电为半导体产业开发优质金刚石材料,利用创新技术促进电子器件的微型化并提高其性能,-贺利氏通过投资巩固其在创新材料技术领域的地位,持续加强多元化产品组合 -化合积电为半导体产业开发优质金刚石材料,利用创新技术促进电子器件的微型化并提高其性能 -此次合作旨在协作开发和市场拓展